.jpg?width=750&height=750&name=YSB55w%E5%8F%97%E6%B3%A8%E7%B5%82%E4%BA%86(zh).jpg)
设备概述
- 实现超过以往机型约3倍的生产率与约2倍的高精度贴装。在不断扩大的倒装芯片市场掀起“半导体组装革命”。
- 可同时高速吸附8个元件并同时高速浸焊,使贴装能力达到13,000UPH
- 高精度 ±5µm(3σ)
- 高品质、通用性强
特征・特点
- 双倒装机头可实现并行工作以及8个芯片的高速同时贴片
- 高刚性框架和控制演算法赋予产品极佳的定位精度
- 搭载可补正Bump位置的高性能摄像机
- 可对应□2~□30mm之间的多种芯片尺寸
- 可简单更改设定助焊剂的浸胶机构
使用实例
焊接工序
可高速对8个元件进行同时吸取和同时转印,贴装能力达到13,000UPH
1.双焊头、多吸嘴(每个焊头可安装8个吸嘴)
标准装配有2个焊头,每个焊头可安装8个吸嘴。能够对载荷进行高精度控制,可对应薄型芯片的贴装。

2.双倒装头
配有2个倒装头,实现了并列处理。

3.多模供料装置
针对1个倒装头,配备有2个供料装置。可以实现不间断元件供给。

高精度 ±5µm(3σ)
1.高刚性框体及横梁
基于彻底的结构分析和全面的验证试验开发而成的高刚性框体,使产品兼具极高的加减速驱动和高精度的特性。

2.自主研发的线性马达/驱动器
通过专用化设计,实现了高速性和卓越的定位精度。
※ 轴停止的测量结果示例

3.高分辨率芯片识别相机
可以精密实施凸点的脱落检查以及按照凸点基准进行位置校正,实现了高精度贴装。

4.可稳定保持高精度
对本公司自主研发的多重贴装精度校正系统MACS进行了功能增强,确保贴装精度达到了±5μm(3σ)。而且,通过采用新开发的热解析/热补正处理方式,也持续维持了高精度贴装。
高品质、通用性强
1.新开发的转印装置
只需点击一下,即可对焊剂转印膜的厚度进行设定与变更,削减成本节约时间。

2.吸嘴站(ANC自动更换吸嘴)
可自动更换能够对应□2~30mm元件尺寸的吸嘴,节省了品种切换的工时。

3.晶片供给装置
标准装配了带有膨胀机构和θ校正机构的晶片供给装置。
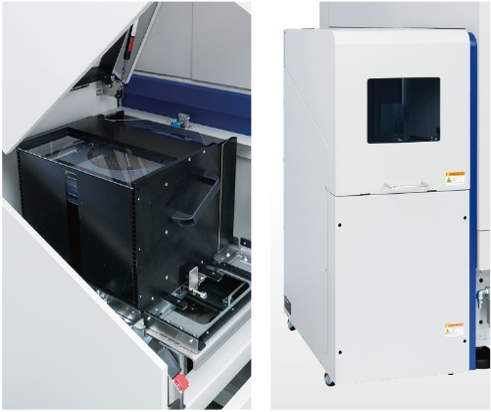
宣传视频
简易规格表
| 项目 | 内容 |
|---|---|
| 型式 | YSB55w |
| 対象基板 | L240×W200~L50×W50mm |
| 基板厚度 | 0.2~3.0mm |
| 传送方向 | 左→右(选购品:右→左传送) |
| 贴装精度 | ±5µm(3σ) |
| 贴装能力 | 13,000UPH(包含实际生产流程时间的最佳条件下) |
| 元件供给形态 | 12英寸晶片 |
| 对象元件 | □2~30mm |
| 电源规格 | 三相AC 200/208/220/240/380/400/416V ±10% 50/60Hz |
| 供给气源 | 0.45MPa以上 |
| 外形尺寸 | L2,090×D1,866×H1,550mm(安装晶片供给装置时) |
| 重量 | 約3,500kg (安装晶片供给装置时) |
※ 因改良需要,规格及外观可能会有所变更,恕不另行通知。







