.jpg?width=750&height=750&name=YSB55w%E5%8F%97%E6%B3%A8%E7%B5%82%E4%BA%86(J).jpg)
概要
- 従来比約3倍の生産性と約2倍の高精度搭載を実現。拡大するフリップチップ市場に「半導体組み立て革命」を。
- 高速 8部品同時吸着・同時転写で13,000UPH
- 高精度 ±5µm(3σ)
- 高品質・汎用性
特長
- デュアルフリップヘッドによるパラレル処理と8部品同時のボンディングプロセスにより、高速搭載を実現
- 高剛性フレームと制御アルゴリズムにより、優れた位置決め精度を実現
- 高性能な位置補正用バンプ認識カメラの搭載
- 小型荷重制御ヘッド
- □2~□30mmの幅広いチップサイズに対応
- 設計変更が容易なフラックス転写ユニットを
使用例
ボンディング工程
高速 8部品同時吸着・同時転写で13,000UPH
1.デュアルボンディングヘッドマルチノズル(8ノズル/ヘッド)
8ノズルのヘッドを2基装備。高精度な荷重制御を行う小型ヘッドでチップの薄型化にも対応。

2.デュアルフリップヘッド
2基のフリップヘッドを装備し、パラレル処理を実現。

3.マルチダイサプライ
フリップヘッド1基に対し2基のサプライユニットを装備。ロスタイム無しで部品供給が可能。

高精度 ±5μm(3σ)
1.高剛性フレーム&ビーム
徹底した構造解析と実験検証に基づいて開発した高剛性フレームにより高加減速駆動と高精度を両立。

2.自社開発リニアモータ/ドライバー
専用設計により高速性と優れた位置決め精度を実現。
※ 軸停止の測定結果例

3.高分解能チップ認識カメラ
バンプの欠落チェックと、バンプ基準での位置補正を精密に行い、高い搭載精度を実現。

4.高精度を安定して実現
当社独自の多重搭載精度補正システムMACSの機能を向上し搭載精度±5μm(3σ)を確保。
新開発の熱解析・熱補正アルゴリズムにより高精度搭載を継続的に維持。
高品質・汎用性
1.新開発転写ユニット
フラックス転写膜厚をワンタッチで設定変更可能。段取り時間と手間を削減。

2.ノズルステーション(ANC自動ノズル交換)
□2~30mmの部品サイズに対応するノズルを自動交換。品種切り替えの手間を削減。
※ 軸停止の測定結果例

3.ウエハ供給装置
エキスパンド機構及びθ補正機構付のウエハ供給装置を標準装備。
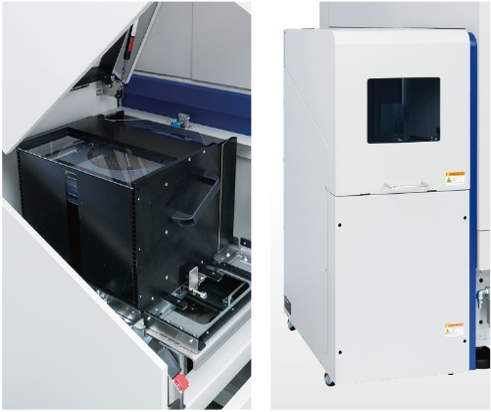
プロモーション動画
製品スペック
| 項目 | 内容 |
|---|---|
| 品名 | パッケージボンダ |
| 型式 | YSB55w |
| 対象基板 | L240×W200~L50×W50mm |
| 基板厚 | 0.2~3.0mm |
| 搬送方向 | 左→右(オプション:右→左) |
| 搭載精度 | ±5µm(3σ)(当社標準部品による保証値) |
| 搭載能力 | 13,000UPH(プロセス時間含む最適条件時) |
| 部品供給形態 | 12インチウエハ |
| 対象部品 | □2~30mm |
| 電源仕様 | 三相AC 200/208/220/240/380/400/416V ±10% 50/60Hz |
| 供給エア源 | 0.45MPa以上 |
| 外形寸法 | L2,090×D1,866×H1,550mm(ウエハ供給装置装着時) |
| 質量 | 約3,500kg (ウエハ供給装置装着時) |
※ 仕様・外観は改良のため予告なく変更することがあります。







